Physical Address
304 North Cardinal St.
Dorchester Center, MA 02124
Physical Address
304 North Cardinal St.
Dorchester Center, MA 02124
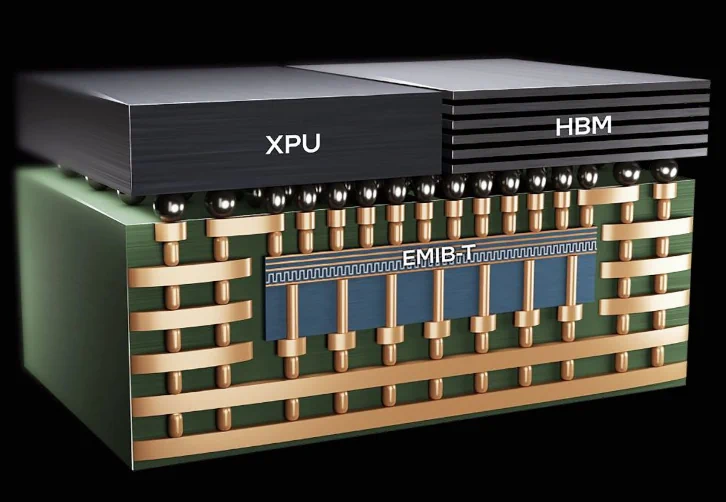
Intel gana terreno con EMIB ante la escasez de CoWoS y atrae a clientes que buscan capacidad, coste y flexibilidad en empaquetado avanzado
Intel vive un momento clave en el negocio de empaquetado avanzado y lo vemos con claridad cuando observamos el giro del sector hacia soluciones que permiten escalar potencia sin depender solo del nodo litográfico. La presión del auge de la IA ha llevado a fabricantes sin fábricas a buscar alternativas reales a CoWoS, la tecnología de referencia de TSMC. La saturación de capacidad ha abierto una ventana que Intel aprovecha con EMIB, una técnica de interconexión que une chips mediante un puente embebido en el sustrato para reducir latencias y mejorar el rendimiento térmico.
En este escenario, se aprecia cómo los clientes estadounidenses necesitan opciones inmediatas. La demanda de CoWoS supera la oferta y obliga a replantear estrategias. Aquí entra EMIB, que ofrece un equilibrio entre coste, escalabilidad y disponibilidad. La ausencia de cuellos de botella en las líneas de empaquetado de Intel se convierte en un argumento decisivo para quienes buscan continuidad en la producción. La propia compañía reconoce un cambio de expectativas. Su dirección financiera explica que los acuerdos previstos ya no se miden en cientos de millones, sino en miles de millones anuales, lo que refleja una transición hacia un volumen comercial real y sostenido.
El interés por EMIB y su variante EMIB‑T crece porque permiten integrar componentes como HBM, ASICs o SoCs móviles sin depender de interposers completos, lo que reduce complejidad y acelera tiempos de fabricación. Esta arquitectura resulta atractiva para diseños que priorizan superficie, eficiencia y flexibilidad frente al máximo ancho de banda absoluto. En un mercado donde cada mes cuenta, disponer de capacidad inmediata se convierte en una ventaja competitiva que pocos pueden ofrecer.
La colaboración estrecha de Intel con proveedores de sustratos en Japón y Taiwán refuerza esta tendencia. Informes recientes indican que estos socios amplían capacidad para anticipar la llegada de pedidos masivos. Este movimiento confirma que EMIB deja de ser una promesa para convertirse en una solución adoptada por clientes de primer nivel. La industria observa este cambio como un síntoma de madurez tecnológica y como una señal de que el empaquetado avanzado ya no depende de un único actor.
Se comenta que NVIDIA estudia EMIB para su familia Feynman, mientras que Apple, MediaTek y Qualcomm valoran esta vía para futuros desarrollos. La motivación no se limita a la tecnología. La fabricación en territorio estadounidense añade un componente estratégico. En la actualidad, Estados Unidos carece de instalaciones de empaquetado avanzado más allá de las de Intel. Esto implica que cualquier chip producido en Arizona por TSMC debe viajar a Asia para completarse, lo que añade riesgo, coste y retrasos. EMIB elimina ese tránsito y ofrece un flujo de producción más directo, algo especialmente relevante en un contexto geopolítico incierto.
El auge del empaquetado avanzado se convierte así en un pilar del futuro de la computación. La IA exige arquitecturas modulares, densas y eficientes, y el empaquetado se transforma en el motor que permite unir bloques especializados. Intel detecta esta oportunidad y la integra en su estrategia de fundición. La combinación de nodos como 18A y 14A con servicios de backend competitivos crea un ecosistema que atrae a clientes que buscan diversificación y capacidad garantizada.
A medida que la demanda global crece, la industria necesita más actores capaces de ofrecer soluciones de alto nivel. EMIB se posiciona como una alternativa sólida, con disponibilidad inmediata y un enfoque pragmático que encaja con las necesidades actuales. La transición hacia arquitecturas chiplet y la presión por aumentar el rendimiento por vatio hacen que este tipo de empaquetado gane protagonismo. La evolución del mercado durante los próximos años mostrará si esta apuesta se consolida como un pilar estable del negocio de Intel.
| Nombre | Intel EMIB / EMIB-T |
| Tipo de tecnología | Puente embebido para interconexión de chiplets |
| Aplicaciones | ASICs, SoCs móviles, soluciones con HBM, chiplets de gran superficie |
| Ventajas principales | Coste reducido, flexibilidad de diseño, menor latencia, alta disponibilidad |
| Fabricación | Capacidad no saturada, producción en EE. UU. |
| Clientes potenciales | NVIDIA, Apple, MediaTek, Qualcomm |
| Perspectiva de ingresos | Pedidos estimados en miles de millones a partir de H2 2026 |
Tendencia ahora